不久前的架构日活动上,intel首次宣布了全新的3d混合封装设计“foveros”,而今在ces 2019展会上,intel宣布了首款基于foveros混合封装的产品,面向笔记本移动平台的“lakefield”。
foveros是一种全新的3d芯片封装技术,首次为cpu处理器引入3d堆叠设计,可以实现芯片上堆叠芯片,而且能整合不同工艺、结构、用途的芯片,可以大大提高芯片设计的灵活性,便于实现更丰富、更适合的功能特性,获得最高性能或者最低能耗。
lakefiled集成了五个cpu核心,分为一个大核心、四个小核心,都采用10nm工艺制造,其中大核心的架构是最近宣布的下一代sunny cove,有自己的0.5mb llc缓存,四个小核心的架构未公布,或许是新的atom,共享1.5mb二级缓存,同时所有核心共享4mb三级缓存。
作为一款完整的soc,它还集成了低功耗版第11代核芯显卡(64个执行单元)、第11.5代显示引擎、4×16-、bit lpddr4内存控制器、各种i/o模块。
lakefield的整体尺寸仅仅12×12毫米,功耗非常之低,而基于它的主板也是intel史上最小的,宽度只比一枚25美分硬币略大一些,长度则只相当于五枚硬币并排。
lakefiled面向移动笔记本设备,可以实现小于11寸的便携式设计,相关产品今年圣诞节前上市。
如对本文有疑问, 点击进行留言回复!!

2年升级一次 Intel:10nm、7nm及5nm工艺开发不会削减投资




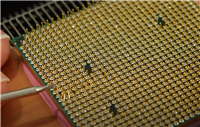
AMD推土机FX-8350超频至8.1GHz!却打不过3.6GHz锐龙

网友评论