越来越艰难的工艺制程,越来越复杂的芯片设计,未来何去何从?作为行业龙头,intel在设计全新cpu、gpu架构和产品的同时,也提出了一种新的、更灵活的思路。
架构日活动上,intel展示了一种名为“foveros”的全新3d芯片封装技术,首次为cpu处理器引入3d堆叠设计,可以实现芯片上堆叠芯片,而且能整合不同工艺、结构、用途的芯片,相关产品将从2019年下半年开始陆续推出。
intel表示,该技术提供了极大的灵活性,设计人员可以在新的产品形态中“混搭”不同的技术专利模块、各种存储芯片、i/o配置,并使得产品能够分解成更小的“芯片组合”。
intel首先回顾了一下近些年新工艺推进的艰难,尤其是针对高性能的计算芯片,14nm工艺已经沿用了长达四年,这在以往是不可想象的。
不过,intel的每代工艺并不是只有一种,而是会针对不同用途的芯片进行不同优化,比如i/o芯片组,其实就在一直进化。
针对下一代工艺规划,intel划分出了三个层次,首先是针对计算的1274 10nm工艺,后续会优化为1274.7、1274.12(10nm+、10nm++),而针对i/o的则是1273,针对新的foveros则设计了p1222,短期内不需要进一步优化。
再往后,计算芯片会进入1276 7nm工艺世代,io、foveros也会同时演进,至于再往后的1278计算芯片工艺,目前还在探索中,不出意外应该对应5nm。
intel表示,不同用途芯片或者功能模块对晶体管密度的需求是截然不同的,性能、功耗、成本也相差很大,因此所有芯片模块都使用同一种工艺不会达到最佳效果,尤其是新工艺越来越难,都硬上新工艺不值得,也越来越不容易做到。
intel此前推出emib(嵌入式多芯片互连桥接)2d封装技术,正是出于这样的目的,典型产物就是整合封装了amd vega gpu图形核心的kaby lake-g处理器。
foveros则升级为3d封装,将多芯片封装从单独一个平面,变为立体式组合,从而大大提高集成密度,可以更灵活地组合不同芯片或者功能模块。
这就是3d foveros 3d封装的结构示意图:最下边是封装基底,之上安放一个底层芯片(bottom chip),起到主动中介层(active interposer)的作用——amd fiji/vega核心整合封装hbm显存就有类似的存在。
中介层之上就可以放置各种不同的新品或模块,比如cpu、gpu、内存、基带……
而在中介层里有大量的tsv 3d硅穿孔,负责联通上下的焊料凸起(solder bump),让上层芯片和模块与系统其他部分通信。
目前,intel已经有了foveros芯片样品,并称已经做好了规模量产的准备,明年就会推出第一款产品,就是上边这个小家伙,intel称之为“混合x86处理器”(hybrid x86 cpu)。
这颗小芯片的长宽尺寸只有12×12毫米,高度仅仅1毫米,还没一枚硬币大,但内部3d堆叠封装了多个模块。
基底之上是p1222 22ffl(22nm工一种)工艺的io芯片,低成本、低漏电。
之上是p1274 10nm工艺计算芯片,也就是传统cpu,内部整合了一个sunny core高性能核心、四个atom低功耗核心(或许是tremont新架构)。
再往上甚至还有pop整合封装的内存芯片。
intel宣称,它的待机功耗只有区区2mw,也就是0.002w,最高功耗也不超过7w,很显然是针对移动平台的,而且不需要风扇,但具体目标设备并没有说。
再来看看这颗处理器的内部组成:右上角就是单个sunny cove cpu核心,有专属的0.5mb mlc中级缓存,左上角是lpddr4x控制器,位宽是四通道的4×16-bit,以及四个小的cpu核心,共享1.5mb二级缓存。
中间是4mb末级缓存,而下方则分布着低功耗版本的11代核显(64个eu单元)、11.5代显示控制器、displayport 1.4控制器,以及其他各种模块。
不过,现场的展示样机平台上还用着小风扇,另外可以看到pci-e m.2接口、ufs闪存、几个sim连接器——难道intel又想重新杀入手机处理器?

2年升级一次 Intel:10nm、7nm及5nm工艺开发不会削减投资




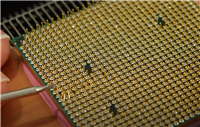
AMD推土机FX-8350超频至8.1GHz!却打不过3.6GHz锐龙

网友评论