intel去年提出了全新的六大战略支柱,其中封装(package)也占据很重要的一个位置。多数人平常更可能更在意xxnm工艺,对于封装知之甚少或者不太在意。
事实上,随着半导体工艺的日益复杂,传统单芯片封装已经渐渐不合时宜,性能、功耗、成本越来越不成比例,尤其是对于高性能芯片来说。
amd刚发布的第三代锐龙以及即将发布的第二代霄龙,就是这种变化的一个典型代表,都用了chiplet小芯片设计,将原本一个单独的大芯片拆分开来,不同模块做成不同的小芯片,再整合到一起。
intel也陆续推出了emib 2.5d、foveros 3d封装技术,前者的代表是去年集成了vega gpu核心的kaby lake-g,后者则会在今年底有lakefiled,融合10nm、22nm。
昨日,intel又公布了三项全新的封装技术co-emib、odi、mdio,基本原则都是使用最优工艺制作不同ip模块,然后借助不同的封装方式、高带宽低延迟的通信渠道,整合在一块芯片上,构成一个异构计算平台。
在现场,intel还拿出了几颗概念性的样品,可以看出在一块基板上都有多达9个裸片(die),且大小、功能各异,整合方式也不一样。
co-emib简单说是emib、foveros的综合体,可以将多个3d foveros芯片互连在一起,制造更大的芯片。
intel介绍的一个示例就包含四个foveros堆栈,每一个都有八个小的计算芯片,通过tsv硅通孔与基底裸片相连,同时每个foveros堆栈通过co-emib连接两个相邻的堆栈,hbm显存和收发器也是通过co-emib组织在一起。

odi更注重互连技术,其全程就是“omni-directional interconnect”,omni-path正是intel用在数据中心里的一种高效互连方式。
一如其名字中directional(方向性)所代表的,odi既可以水平互连,也可以垂直互连,而且通孔更大,所以带宽高于传统tsv,电阻和延迟则更低,此外电流还可以直接从封装基底供给到裸片。
它所需要的垂直通孔通道数量也少于传统tsv,因此可以减小裸片面积,可容纳更多晶体管和更高性能。
mdio意思是multi-die io,也就是多裸片输入输出,是aib(高级互连总线)的进化版,为emib提供一个标准化的sip phy级接口,可互连多个chiplet。
针脚带宽从2gbps提高到5.4gbps,io电压从0.9v降低至0.5v,并且号称比台积电最近宣布的lipncon高级的多。
如对本文有疑问, 点击进行留言回复!!

2年升级一次 Intel:10nm、7nm及5nm工艺开发不会削减投资




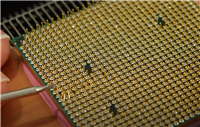
AMD推土机FX-8350超频至8.1GHz!却打不过3.6GHz锐龙

网友评论