2015年代号为fiji的amd fury x显卡发布,代表着hbm显存第一次进入大众视野,将传统传统的2d显存引向立体空间。通过堆叠,单个die可以做到8gb容量,位宽也高达1024bit。相比之下传统的ddr显存单die只有1gb容量,位宽只有32bit。
因此hbm显存可以很轻易的做到32gb容量、4096bit带宽,同时不需要太高的频率就能达到传统的gddr5显存所无法企及的恐怖带宽。
2017年,随着zen构架的锐龙处理器问世,amd也让我们见识到了mcm(multichip module)技术。采用模块化设计的锐龙处理器单个ccd含有8个核心,将2个ccd封装在一起就能变成16核,32核的撕裂者2990wx拥有4个ccd。
mcm技术的出现使得多核扩展变得更加简单高效,同时也避免了大核心带来的良率问题,因此在成本上要远远优于竞品。

而2019年的zen 2构架则将mcm技术再一次升级为chiplet。通过将cpu die与i/o die进行分离,cpu die可以做的更小,扩展更多核心的时候也相应的变得更加容易,同时也进一步降低的了多核处理器的制造成本。按照amd的说法,在某些情况下,chiplet设计可以将处理器制造成本降低一半以上。
在今天早上的amd财务分析大会上,amd ceo 苏姿丰又向大家展示了一种名为x3d的封装技术,它是在原有的chiplet技术上加入了hbm的2.5d堆叠封装。虽然amd没有明说,但是意图非常明显,未来的高性能处理器极有可能会引入hbm内存,从而将内存带宽提升10倍以上。
如果顺利的话,我们在zen 4构架上就能看到这种设计,新一代amd处理器的性能相当令人期待!
如对本文有疑问, 点击进行留言回复!!

2年升级一次 Intel:10nm、7nm及5nm工艺开发不会削减投资




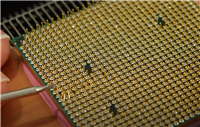
AMD推土机FX-8350超频至8.1GHz!却打不过3.6GHz锐龙

网友评论